¿Qué es Reballing?
Reballing es una técnica avanzada desarrollada para dispositivos BGA que consiste en retirar el componente de la tarjeta donde ha sido soldado, reemplazar sus esferas de soldaduras y efectuar nuevamente el proceso de soldado del componente manteniendo el control estricto del perfil de temperatura recomendado por el fabricante del chip. Usualmente este procedimiento se utiliza cuando se ha detectado el mal funcionamiento del componente por microfacturas en sus esferas de soldadura y no hay disponible una alternativa diferente para recuperar la funcionalidad de un producto electrónico. La siguiente gráfica ilustra esta tipo de falla.
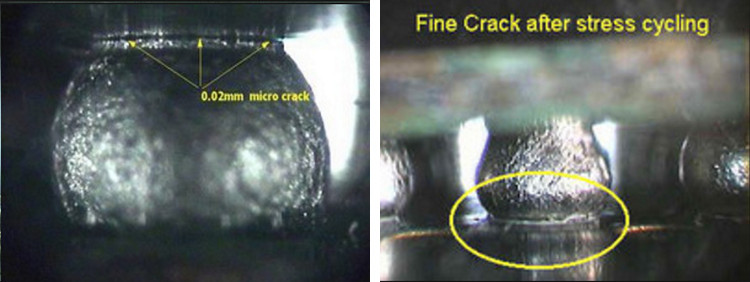
¿Por qué realizar este procedimiento?
Este proceso es usado como alternativa de reparación cuando una vez detectada la falla, retiramos el componente destruyendo sus esferas de soldadura y nos encontramos en uno de los siguientes escenarios al tratar de adquirir uno nuevo para su reemplazo:
- Por vencimiento de la garantía del producto donde la tarjeta está alojada expirando el derecho a su reparación sin costo.
- No podemos obtener del fabricante de la tarjeta el mismo componente por tener en su interior un Firmware de propietario y este se niega a suministrarlo.
- Si se ha detectado que el componente está defectuoso en su interior y se va a reemplazar por otro extraído de otra tarjeta donde el dispositivo no sea la causa de su mal funcionamiento.
- Para recuperar la vida útil de un computador, consola de videojuegos o cualquier tarjeta que tenga componentes BGA.
¿Qué normas IPC aplican para certificar este proceso?
El proceso de Reballing debe realizarse bajo las especificaciones IPC-7711 /Procedimiento 5.7.3 BGA Reballing Procedure y deberá obligadamente implementarse el control de la humedad absorbida por el componente ajustándose a la norma e IPC/JEDEC J-STD-020, extrayéndola previamente al procedimiento de soldado si fuera necesario.
¿Cómo se realiza profesionalmente este proceso?
Industrialmente se efectúa utilizando sistemas que cumplan como mínimo con las siguientes características:
- Sistema de alineación de alta precisión para la colocación correcta del componente.
- Que aplique calor controlado para el precalentar la parte inferior de la tarjeta.
- Que el perfil de temperatura que aplique al componente para todo el proceso sea el recomendado por el fabricante del chip.
- Que tenga trazabilidad impresa del perfil aplicado durante el proceso para soporte al cliente.
El siguiente video ilustra el proceso de Reballing completo efectuado en una maquina a nivel industrial.
¿Qué diferencia hay con el proceso de Reflow?
El Reflow o “soplado” es un proceso simple donde se aplica aire caliente sobre chip que tiene la falla para lograr eventualmente que las soldaduras intermitentes vuelvan a hacer contacto.
Este procedimiento es usado en el 99% de los casos cuando llevamos a reparar una tarjeta con este tipo de problema y por lo tanto tiene muy escasas probabilidades de obtener un buen funcionamiento a largo plazo al no poder aplicar flux a las superficies a soldar ni controlar el perfil de temperatura aplicado. En la siguiente imagen se puede observar como es implementado normalmente este proceso:

Usualmente puede durar unos pocos meses razón por la cual quienes implementan este proceso dan poco tiempo de garantía y debido a la falta de control de sus parámetros puede conducir a la pérdida del equipo por sobrecalentamiento del PCB al momento de efectuar el proceso y a la frustración al recibir eventualmente el mensaje de que el chip ya no sirve o que es otro daño que no vale la pena reparar. No es nada aconsejable debido a su alto costo casi similar al proceso de Reballing.
¿Por qué es tan común este tipo de fallas en las soldaduras de un componente BGA?
- Excursiones del producto electrónico a temperaturas altas por diseño deficiente del producto o por obstrucción de su ventilación, lo que produce el deterioro de las uniones entre la esfera de soldadura y los pads del componente y del PCB.
- Fallas en el proceso de soldadura del componente donde probablemente se han producido uniones de soldadura porosas o deficientes.
- Mezcla de soldaduras y acabados de circuitos impresos no compatibles aumentando el riesgo de producir uniones defectuosas o de poca fortaleza.
- Las capas intermetálicas que se forman en la unión Pad del BGA–Esfera de soldadura-Pad del PCB en un chip BGA son la parte más importante de una soldadura pero a su vez es el componete más frágil de la soldadura y son sensibles a microfisuras producidas por fatiga (Stress) mecánica y térmico debido a la exposición acumuladas a las vibraciones y altas temperaturas durante el funcionamiento normal del producto.
Para quienes deseen ilustrarse técnicamente acerca de este fenómeno pueden acceder al siguiente enlace:
Los intermetálicos en la soldadura
¿Cómo se manifiesta este tipo de daño?
- En los computadores portátiles usualmente prende pero no se observa nada de video lo que la mayoría de veces es ocasionado este tipo de daño intermitente en las soldaduras del Chip de video.
- En las consolas de videojuegos XBOX luces rojas y amarillas en las PS3.
- En otro tipo de tarjetas su manifestación depende de la funcionalidad del producto y debe ser evaluada por procesos especializados como inspección de soldaduras por Rayos X,
¿Cómo prevenir este tipo de falla?
- Si un producto por su requerimiento debe incluir el uso de componentes BGA, entonces se debe diseñar todo el producto teniendo en cuenta el riesgo de falla de sus soldaduras por efecto de la temperatura si no se toman las medidas del caso para que circule sin obstáculos el aire caliente generado por el funcionamiento de la tarjeta y se evacue rápidamente y lejos del componente.
- Efectuar el mantenimiento preventivo el cual se ha convertido en una filosofía olvidada que indudablemente alargaría la vida útil de este tipo de productos. Esto permitiría si se hace bien, mantener limpios los conductos de ventilación de los equipos así como la lubricación adecuada de los ventiladores del producto ya que por efecto del tiempo, polvo y temperatura, sus lubricantes se secan disminuyendo cada vez más su eficiencia.

- El cambio de grasa disipadora en los procesadores, Chips de video en los computadores y consolas de juego y en dispositivos BGA que tengan disipador es absolutamente vital ya que dicha grasa se seca con el tiempo perdiendo cada vez más su propiedad de transferencia de calor ocasionando que el componente trabaje a una mayor temperatura de lo normal y por lo tanto disminuyendo la vida útil de sus soldaduras.
- El polvo es uno de los mayores enemigos para los computadores portátiles y las consolas de juego ya que obstruye los conductos de ventilación forzando los extractores a trabajar al máximo. Esto es evidenciado por el aumento de ruido del mismo al cual normalmente no hacemos caso hasta que el equipo presenta la falla.
¿Cómo garantizar la confiabilidad a largo tiempo del procedimiento?
- Si el análisis previo confirma que existen fisuras en las esferas de soldadura del componente BGA, un procedimiento calificado de Reballing garantiza el restablecimiento de las condiciones iniciales de ensamble del componente y la integridad de la tarjeta.

- Básicamente debemos elegir un proveedor del servicio que tenga las herramientas adecuadas para la implementación controlada de la temperatura del proceso y que eventualmente pueda certificar su resultado usando el método de inspección por rayos X, sistema único que puede ver a través del componente para comprobar la calidad de las soldaduras de un dispositivo BGA como lo ilustra la figura superior.
- Solicitar pruebas de trazabilidad como filmación de los videos de los procesos de inspección por rayos X o del procedimiento de Reballing suele en la mayoría de los casos detectar la falsedad de los procesos que el usuario paga por implementar.
¿Es compatible con todos los tipos de componentes BGA?
Infortunadamente no. Debido su alto costo debemos conocer que este procedimiento no produce resultados satisfactorios a largo plazo en componentes tipo Flip-chip BGA y que ante un eventual buen funcionamiento después de efectuado el proceso, su duración será cada vez más corta.
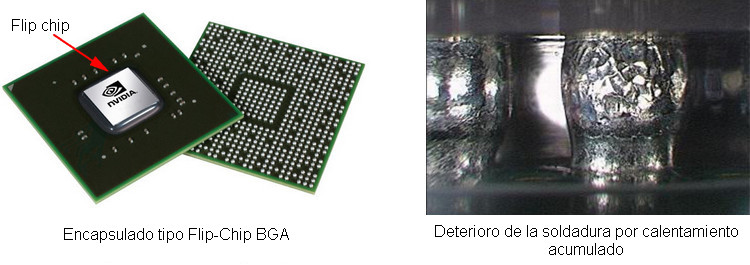
La razón es que el procedimiento de reballing normalmente reemplaza las esferas de soldadura que se encuentran en la parte inferior del componente y que tienen un diámetro en el rango de 0.6 mm y no las microesferas que tienen un diámetro en el rango de 75 μm. y que están encapsuladas herméticamente entre el componente Flip-chip y el sustrato BGA y que se deteriorarán más cada vez que realicemos el proceso por efecto de la ata temperatura como se ilustra en la figura derecha.
Conclusiones:
El costo de una tarjeta es un factor determinante para hacer atractivo un procedimiento de Reballing que además permite reciclar electrónica, recuperar inversión, etc. Cualquiera que sea la razón para considerar esta alternativa de reparación exige la elección de personas o empresas calificadas que utilicen las herramientas adecuadas para lograr que el proceso sea exitoso.
Bibliografía:
- Circuit Insight. Options for Reballing BGA Components
http://www.circuitinsight.com/programs/54113.html
PRECAUCIÓN: Las anteriores consideraciones están basadas en las experiencias y prácticas comunes de los procesos de ensamble y soldadura de circuitos impresos y son publicadas con propósitos educativos solamente. Úselas bajo su propio riesgo con otros fabricantes.